אפיטקסיית קרן מולקולרית
אפיטקסיית קרן מולקולרית (באנגלית: Molecular-beam epitaxy), המוכרת בראשי התיבות MBE, היא שיטת אפיטקסיה לגידול שכבות דקות חד-גבישיות (אנ') של יסודות או תרכובות ישירות מהיסודות או מהתרכובות שלהם, המנודפים בוואקום אולטרה-גבוה - UHV (10-11 טור) על מצע גבישי מחומם. שליטה הדוקה בשטפים של היסודות המזינים את הגידול בשיטת ה-MBE מאפשרת דיוק בעובי השכבה המגודלת ברמת של שכבה אטומית בודדת. העבודה ב-UHV מאפשרת יישום שיטות שונות של ניטור ובקרה של הקרניים המולקולריות ושל הגביש הגדל תוך כדי האפיטקסיה.
עקרון הפעולה של MBE[עריכת קוד מקור | עריכה]
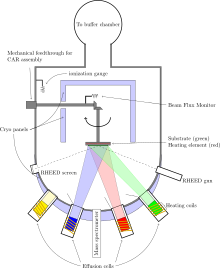
גביש המצע עליו רוצים לגדל מונח על מחזיק בתא עם וקואום אולטרה גבוה (ראו איור 1). בין השאר מוקף התא במעטפת (shroud) מלאה בחנקן נוזלי, הפועלת כמשאבת ספיחה. המצע מחומם לטמפרטורה רצויה באמצעות גופי החימום שמאחוריו. ממולו יש תנורים קטנים שבתוכם כוריות (crucibles) הממולאות ביסודות הרצויים. חימום כל תא כזה גורם להתאיידות היסוד המצוי בתוכו. לכל תא יש פתח קטן יחסית, שממנו יוצאים היסודות שהתנדפו, ולכן הם פועלים כתאי אפוזיה (תאי נודסן (אנ') Knudsen). לפני כל תא, וקרוב יחסית אליו, מצוי חָסַם (shutter), אותו ניתן להניע כך שימצא מול התא ויחסום את פתחו, או שימצא בעמדה שונה כך שהפתח פתוח. כשהחסם נמצא ממול לפתח התא (מצב סגור) החומר שמנודף מהתא פוגע בו ושוקע עליו (כך בתא הצהוב שבחלק השמאלי של תא הגידול באיור). כאשר החסם במצב פתוח, כלומר איננו מול פתח תא האפוזיה, האטומים או המולקולות שיוצאים מן התא יכולים להגיע למצע, ולהצטרף לגביש הגדל. זה המצב בתאים שבצבע ירוק, אדום וכחול באיור. היסודות יוצאים מכל תא במהירויות קוויות גבוהות, בהתאם לטמפרטורה הגבוהה של התא. מפני שבתנאי UHV האווירה בתא אינה מכילה כמעט אטומים אחרים, המהלך החופשי הממוצע של היסודות היוצאים מתא האפוזיה ארוך מאוד. הם לא יתנגשו למעשה בשום דבר עד שיפגעו במצע או בדופן המערכת. כל תא פולט, אם כן, קרן של אטומים או מולקולות, ומכאן שמה של השיטה.
קרן האטומים או המולקולות פוגעת במצע (או המצעים) המצויים על מחזיק מסתובב, ונספחים לפני השטח שלו. האפיטקסיה מושגת הודות לחימום המצע. כך מאפשרים לאטומים "לטייל" על פני השטח, כדי שימצאו לעצמם את המקום המועדף (אנרגטית), "להתיישב" בו, ולהצטרף לגביש.
במהלך הגידול פותחים וסוגרים את החסמים של התאים בהתאם לחומרים אותם רוצים לגדל. אם למשל התא הירוק באיור 1 מיצג תא המכיל בתוכו ארסן, האדום - תא המכיל גליום, הכחול - תא המכיל אלומיניום, והצהוב - תא המכיל אינדיום, אז במצב המתואר באיור 1, שבו חסם האינדיום סגור ואילו חסמי הארסן, האלומיניום והגליום פתוחים, מגודלת סגסוגת של אלומיניום גליום ארסניד (אנ') (AlGaAs). אם סוגרים כעת את החסם של תא האלומיניום, ומשאירים את החסמים של הארסן והגליום פתוחים, תגדל שכבה של גליום ארסניד (GaAs). ברגע שייפתח החסם של תא האינדיום תתחיל לגדול הסגסוגת אינדיום גליום ארסניד (אנ') (InGaAs).
קצב הגידול[עריכת קוד מקור | עריכה]
קצב הגידול של השכבה תלוי בראש ובראשונה בשטף האטומים מכל סוג המגיעים לפני השטח. זה מצדו תלוי בטמפרטורה של תא האפוזיה. השטף הזה, ϕ, נמדד על ידי מדיד (אנ') הוקואום, שלצורך העניין קרויה הקריאה שלו הפעם beam equivalent pressure (BEP), ומסומנת ϕBEP. ב-MBE, כמו באפיטקסיה בשיטות אחרות, מגדלים בעודף של אספקת אטומי האל-מתכת. אטומים אלו יותר נדיפים (בדרך כלל) מאטומי המתכת, כך שעודף שלהם מונע פירוק של המצע או השכבה הגדלה, והם אינם נוטים להצטבר על פני השטח, כטיפות או גבישונים, כפי שקורה כשאטומי המתכת הם בעודף. יש לכך השפעה על ההתנהגות של קצב הגידול, שכן במצב זה ϕBEP-Metal הוא הגודל הקובע את הקצב: rg = C ϕBEP-Metal, היכן ש-rg הוא קצב הגידול של השכבה, ו-C הוא קבוע המתקבל ממדידות ניסיוניות, והמכיל בתוכו את כמות האטומים של המתכת הנדונה בחלק תא היחידה המרכיב חד-שכבה (monolayer – ML) במוצק הגדל, את מקדם ההידבקות של האטום הנידון (החלק היחסי מהשטף המגיע, הנשאר על פני השטח ולא מתנדף חזרה, שתלוי בטמפרטורה ובמצע), ואת הגאומטריה של תא הגידול. הקצב אינו תלוי בזמן, ולכן עובי השכבה מתקבל בפשטות מהכפלת הביטוי עבור rg במשך הגידול.
הרכיבים של מערכת הגידול[עריכת קוד מקור | עריכה]
לב מערכת הגידול הוא תא הגידול (הריאקטור), שבו מתבצעת האפיטקסיה. הריאקטור הוא תא וקואום, המצויד במשאבות חזקות מאוד ובמשאבה פנימית, המעטפת הממולאת חנקן נוזלי (הקריו-פנל), שמביאים יחדיו את הלחץ בתא לרמה של Torr 10-11. יש בו, כמוראה באיור 1, את המניפולטור, המחזיק את פלטת המצעים, מחמם ומסובב אותה (להשגת אחידות השכבה הַגְּדֵלָה). יש בנוסף אמצעים להכנסת הפלטה מתא מעבר ותא הכנות לתא הגידול, אך אלו לא מוראים באיור 1 אלא בתמונת המערכת (תמונה 1).
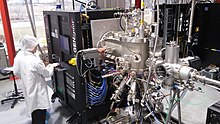
בריאקטור פתחים שעליהם מורכבים תאי האפוזיה, ולתוכם מטעינים (מראש) את החומרים. בתנאי ההפעלה היסודות המתכתיים (מטור III (אנ') בטבלה המחזורית, עבור מוליכים למחצה III-V) הם בדרך כלל נוזליים. (אפשר להשתמש במקורות מטלו-אורגניים, כמו ב-MOVPE, ואז השיטה נקראת MOMBE.) היסודות האל-מתכתיים (מטור V (אנ'), במקרה של גידולי III-V) הם בדרך כלל מוצקים שממריאים (עוברים סובלימציה) בחימום. (אפשר להשתמש גם במקורות גזיים, כמו ארסין (אנ'), AsH3, או פוספין, PH3, ואז השיטה קרויה GS‑MBE – gas source MBE.) בגידולי ניטרידים (אנ') או תחמוצות, האניונים הם תמיד גזיים.
העובדה שהאפיטקסיה ב-MBE מתרחשת ב-UHV מאפשרת שימוש במגוון של אמצעי אִבְחוּן (דיאגנוסטיקה) פנימיים (in situ) כמוראה באיור 1. ראשית, יש את האמצעים ל מדידת לחץ (אנ') (ionization gauges) ולמדידה מדויקת של טמפרטורות המצעים במהלך הגידול (פִּירוֹמֶטֶר (אנ'), לא מוראה באיור 1). בנוסף יש גם תותח אלקטרונים ומסך פלואורסצנטי למדידות RHEED (reflection high energy electron diffraction) לבחינת האיכות הגבישית של פני השטח, מד לחץ למדידה של שטף החלקיקים בקרניים המולקולריות (BFM – beam flux monitoring), ספקטרומטר מסות למדידת הסוג והכמות של הגזים השיוריים במערכת, ה-RGA (אנ'), ולפעמים עוד מכשירים נוספים המאפשרים, למשל, אפיון כימי של פני השטח של השכבה האפיטקסיאלית, כמו ספקטרוסקופיית אלקטרוני אוז'ה (AES).
אפיון מבנה פני השטח באמצעות RHEED[עריכת קוד מקור | עריכה]
 ערך מורחב – עקיפת אלקטרונים גבוהי-אנרגיה מוחזרים
ערך מורחב – עקיפת אלקטרונים גבוהי-אנרגיה מוחזרים
אחת משיטות האבחון הייחודיות לאפיטקסיה באווירת UHV כמו MBE ושיקוע בְּדִפְקֵי לייזר (אנ') (pulsed laser deposition, PLD) היא עקיפת אלקטרונים גבוהי-אנרגיה מוחזרים (reflection high energy electron diffraction, RHEED). בטכניקה זו נורים אלקטרונים באנרגיה גבוהה (5–40 קילו-אלקטרון-וולט) מתותח אלקטרונים אל עבר הדגם, בזווית לוחכת (1°-3°), כמוראה סכמתית באיור 2. אלקטרונים אלו מוחזרים ועוברים עקיפה (דיפרקציה) מפני השטח של הדגם, ויוצרים תבנית על מסך פוספורסצנטי בצד המערכת שמנגד לתותח האלקטרונים. את התבנית הזו ניתן להקליט באמצעות מצלמת CCD לניתוח איכותי וכמותי בזמן אמת, או במועד מאוחר יותר. בגלל זווית הפגיעה הרדודה של קרן האלקטרונים, העברת האנרגיה בניצב לפני השטח מינימלית, ובעיקר מפוזרים האלקטרונים אלסטית רק מכמה שכבות אטומיות בודדות של החומר. עובדה זו הופכת את טכניקת RHEED להיות רגישה מאוד לסידור הגבישי על פני השטח, ובכך היא מספקת מידע מִבְנִי לגבי פני השטח של המצע ושל השכבה הגדלה.

בגלל הרגישות הגבוהה לסידור האטומי על פני השטח, והעדר אביזרים בדרכם של האלקטרונים המוחזרים מפני השטח (כמו ב-LEED (אנ')), RHEED היא כלי חשוב בניטור ובקרה באפיטקסיה. אבל היא מוגבלת רק לאפיטקסיה בסביבת UHV, מכיוון שמולקולות האוויר מאיטות במהירות את האלקטרונים שבקרן. במהלך גידול MBE או PLD היא משרתת את המגדל בצורה הבאה:
- מתן אינדיקציה מתי סולקה התחמוצת הטבעית מפני המצע (העלמות הרקע החלבי במסך ה-RHEED והופעת תבנית העקיפה)
- מצב פני השטח - האם הם חלקים או מחוספסים, ובכלל זה האם יש עליהן מדרגות בכיוון מסוים (ראו איור 2)
- האם הגידול מתקדם בצורה דו-ממדית או בצורת איים תלת-ממדיים (ראו איור 2)
- עבור אפיטסקסיה של תרכובות: האם הגידול הוא בעודף מתכת או בעודף אל-מתכת (לפי שינוי הרקונסטרוקציה המשטחית (אנ') . למשל, באפיטקסיה של GaAs בעודף As הרקונסטרוקציה האופיינית היא 2x4, ואילו בעודף Ga היא בדרך כלל 4x2)
- קביעת קצב הגידול (מהתנודות של עוצמת ה-RHEED).
תנודות (אוסצילציות) RHEED וקביעת קצב הגידול[עריכת קוד מקור | עריכה]
ברישום של עוצמת קרן ה-RHEED המוחזרת או מפוזרת מפני השטח במהלך גידול MBE מתגלות תנודות (וידאו 1). תנודות אלו נובעות מהבניה של השכבות האטומיות אחת על גבי השנייה. כל שכבה מתחילה להתגבש כאיים דו-ממדיים ההולכים וגדלים עד להתמזגותם לשכבה רציפה, שעליה מתגרענים שוב איים דו-ממדיים, הגדלים ומתמזגים, וחוזר חלילה. כשהשטח חופשי מאיים (חלק) הוא מחזיר את קרן ה-RHEED בעוצמה גבוהה, ההולכת וקְטֵנָה כשהאיים מתגרענים וגְדֵלִים. משכוסתה מחצית השטח באיים עוצמת הקרן מתחילה שוב לעלות עם התמזגות האיים, עד למקסימום, כשהשכבה רציפה. כל מחזור מייצג, אם כן, בנייתה של שכבה אטומית אחת. מסיבה זו אוסצילציות ה-RHEED הן כלי חשוב לחישוב קצב הגידול באפיטקסיה.[1]
על מנת להבטיח קבלת אוסצילציות ברורות משתמשים במצעים שחתוכים במדויק במישור גבישי ראשי (מישור סינגולרי), שאם לא כן, הקיום של מדרגות על פני השטח עלול להפריע לקיום המנגנון של יצירת איים דו-ממדיים והתמזגותם.[2] למרות זאת, כפי שניתן לראות בווידאו 1, עוצמת התנודות דועכת, עד להיעלמותן המוחלטת, מפני שאף מחזור לא מסתיים בשכבה מלאה לגמרי. האיים מתחילים להתגרען על גבי השכבה לפני שכל האיים הדו-ממדיים בה התמזגו לגמרי, ופני השטח נהיים מחוספסים. אם בתום הגידול השכבה נשארת בטמפרטורת הגידול (בשטף הגנה של היסוד הנדיף - האל-מתכתי בדרך כלל), יכולים פני השטח המחוספסים להתארגן מחדש, ליצירת שכבה חלקה מלאה כמעט לגמרי, והעוצמה עולה בחזרה, כמעט לערכה ההתחלתי. בגידול מחדש בשלב זה, תופענה שוב התנודות.
יתרונות וחסרונות של MBE[עריכת קוד מקור | עריכה]

אחד היתרונות הגדולים של MBE הוא האפשרות לגדל בטמפרטורה נמוכה בעשרות, ואף מאות, מעלות צלזיוס מאשר בשיטות מתחרות כמו MOVPE. הסיבה לכך היא, שבעוד שב-MOVPE צריך לחמם את המצע לטמפרטורה גבוהה מספיק כך שהמולקולות האורגנו-מתכתיות תעבורנה פירוליזה כדי לתת את היסודות, שיצטרפו לשכבה הגדלה, ב-MBE מפרידים בין הטמפרטורה (הגבוהה יחסית) הדרושה ליצירת היסודות הללו (על ידי חימום המקורות שבתאי האפוזיה), ובין הטמפרטורה האופטימלית (הנמוכה יותר) הדרושה לגידול שכבה איכותית, שאליה מחממים את המצע. טמפרטורת הגידול הנמוכה יותר מאפשרת גידול שכבות טהורות יותר (עם פחות זיהומים), ובעיקר, מסודרות יותר גבישית ועם ממשקים חדים יותר בין השכבות המרכיבות את המבנה המגודל.
היכולת להשיג מעברים חדים בהרכב השכבות בממשקים נובעת גם מעצם העובדה של השימוש בקרניים המולקולריות. בגלל המהירות הגבוהה מאוד של המולקולות או האטומים בקרניים, ומפני שתנועת החסמים מהירה מאוד (מספר אלפיות של שנייה), הקרניים "נדלקות" ו"כבות" במהירות, בניגוד להתחלה ולהפסקה של זרימת הפרקורסרים בצינורות המזינים את הריאקטור ב-MOVPE, למשל. מסיבה זו MBE היא השיטה המועדפת לגידול על-סריגים (אנ') (איור 3).
אווירת ה-UHV שבה מתבצע הגידול ב-MBE מעניקה לשיטה יתרונות גדולים: ראשית, היא מבטיחה רמת ניקיון גבוהה יותר מאשר בשיטות אפיטקסיה אחרות, למשל MOVPE. לבטח יש פחות פחמן בשכבות ה-MBE מאשר ב-MOVPE. שנית, היא מאפשרת שימוש במגוון רחב של אמצעי אבחון (דיאגנוסטיקה) ובקרה (control) פנימיים, כמפורט למעלה. אבל, מאחר שמדובר במערכת UHV, ומאחר ומדובר בקרניים שמצריכות מרחקים של עשרות ס"מ ויותר בין המקורות למצעים (להשגת אחידות שטף בקרניים), הטיפול במערכות ה-MBE וְהַגִּמְלוּן (scale-up) שלהן קשה (ויקר) יותר מאשר בשיטות האחרות. תאי ה-MBE התעשייתיים מכילים פחות מצעים מאשר מערכות MOVPE תעשייתיות, עובדה המייקרת עוד את הייצור של שכבות ב-MBE.
ההיסטוריה המוקדמת של MBE[עריכת קוד מקור | עריכה]
המונח Molecular bean epitaxy הוצג לראשונה ב-1970 בסימפוזיון הבינלאומי השלישי על GaAs ותרכובות קשורות (Third International Symposium on GaAs and Related Compounds) על ידי אלפרד (אל) צ'ו (אנ'), מורטון פאניש (אנ') ואיזואו היאשי (אנ'),[3] על מנת להבחין בין שיטת האפיטקסיה שהם פיתחו במעבדות בל במאריי היל (אנ'), ניו ג'רזי, בסוף שנות ה-60 של המאה ה-20, ובין שיטות האפיטקסיה המוקדמות יותר: אפיטקסיה מהפאזה הגזית (VPE) ואפיטקסיה מהפאזה הנוזלית (LPE). אבל, העבודה הראשונה על הומואפיטקסיה של GaAs, שיכולה להיחשב כ-MBE, פורסמה בין השנים 1964 ו-1968 על ידי ג'ון דייווי וטיטוס פנקי (אנ') ממעבדת המחקר של צי ארצות הברית בוושינגטון הבירה.[4][5] בעבודה זו קיימים מרבית המרכיבים של תהליך ה-MBE: קרן מולקולרית (של הגליום), מצע מחומם שהוסרה ממנו התחמוצת בתוך הריאקטור (על ידי התזה, sputtering), וואקום גבוה (נמוך מ-10-6 טור), ועודף ארסן. למעשה הייתה זו העבודה הראשונה שבה יושמה באפיטקסיה "שיטת שלוש הטמפרטורות" של Günther.[6] שיטה זו נועדה להתגבר על בעיית ההתפרקות התרמית של התרכובות הבינאריות המגודלות, בגלל ההפרש הגדול בלחצי האדים של היסודות המרכיבים אותן. בשיטה זו מחממים את המקורות לשתי טמפרטורות שונות (את היסוד המתכתי לטמפרטורה גבוהה, ואת היסוד האל-מתכתי לטמפרטורה נמוכה), ואילו את המצע מחממים לטמפרטורת ביניים, שלישית. גינטר עצמו יישם את השיטה לגידול InAs (אנ') ו-InSb (אנ'), אך על מצעי זכוכית, כך שהתקבלו שכבות רב-גבישיות, ולכן לא הייתה זו אפיטקסיה.
העבודה של דֵייוִוי ופָּנָקִי חסרה, עם זאת, מרכיבים מסוימים הקיימים ב-MBE: סביבת הגידול לא הייתה באמת UHV (כי הריאקטור עצמו חומם, ולא קורר לטמפרטורות קריאוגניות), אדי הארסן לא הגיעו לפני המצע כקרן מולקולרית, ולא היו במערכת אמצעי אבחון (דיאגנוסטיקה) פנימים. כל אלו יושמו לראשונה באפיטקסיה של סיליקון ו-GaAs על ידי ב. א. ג'ויס ושותפיו בחברת Plessey (אנ') האנגלית החל מ-1966.[7] ולאחר זמן קצר, ב-1968, בתרכובות של GaAs ו-GaP על ידי ארת'ור ולה-פור במעבדות בל,[8] תוך התבססות על המחקרים הקודמים באותן מעבדות על האינטראקציה בין קרניים מולקולריות של Ga ושל As2.[9] אך הייתה זו שעתה המכרעת של שיטת ה-MBE כשג'ויס עבר למעבדות המחקר של מוּלַרְד (אנ') (לימים פיליפס) ברֶדְהִיל (אנ'), בסארי, אנגליה, וכאשר אל צ'ו הצטרף למעבדות בל. שניהם, ובעיקר צ'ו, שיקרא לימים "אבי ה-MBE", תרמו רבות להבנה של תהליך ה-MBE, וליישומו למימוש התקנים חשמליים ואלקטרו-אופטיים.
אחד היתרונות הגדולים במערכת המקורית של אל צ'ו היה יכולת השימוש ב-RHEED המאפשרת (בניגוד ל-LEED, שהייתה השיטה המקובלת באותם ימים לחקר פני השטח של מוצקים) ניטור הגידול בזכות הצפייה בתמונת העקיפה של האלקטרונים מפני השטח במהלך האפיטקסיה עצמה.[10][11] למעשה היה זה צ'ו שעמד על כך שתמונת הדיפרקציה המתקבלת מפני השטח ב-MBE אינה תוצאה של שכבת מזהמים ספוחה, כפי שהיה מקובל לחשוב, אלא מסידור שונה של אטומי הגביש עצמו על פני השטח שלו. הוא הראה את הקשר בין תבנית העקיפה המתקבלת ובין תנאי הגידול. נושאים אלו הורחבו בהמשך על ידי ניב וג'ויס.[12] אל צ'ו היה הראשון להראות שעבור GaAs, המגדל יכול לוודא באמצעות ה-RHEED האם ומתי סולקה התחמוצת הטבעית מפני המצע (ועל ידי כך למנוע גידולים בלתי מוצלחים על מצע מכוסה בתחמוצת או מזוהם), האם תנאי הגידול הם עשירים בגליום או בארסן, והאם הגידול מתרחש בצורה דו-ממדית, כמתוכנן, או שמתפתחים על פני השטח איים תלת-ממדיים.[10][13]
ההתקדמות הבאה באפשרויות ההבנה והשליטה בגידול ב-MBE התרחשה ב-1981 עם גילוי התנודות (אוסצילציות) בעוצמת קרני ה-RHEED במהלך הגידול.[14][15] בהתחלה חשבו שתופעה זו ייחודית רק לגידולים מסוימים, כמו גידול GaAs בנוכחות בדיל. אבל, אז התברר שהתופעה היא כללית, והיו אלו ניב וג'ויס ממעבדות פיליפס ביחד עם דובסון ונורטון מהקולג' הקיסרי למדע וטכנולוגיה בלונדון, שסיפקו את ההסבר לתופעה.[1] הגילוי והסברו המוצלח הזניקו את אפשרויות השליטה ב-MBE, שכן אפשרו קביעה מדויקת של קצב הגידול, ושל ההרכב הכימי של סגסוגות, כדוגמת AlxGa1-xAs. ההבנה שדעיכת העוצמה של האוסצילציות פירושה גידול ברמת החספוס של פני השטח הגדלים, ושהתאוששות עוצמת הקרן בסיום הגידול פירושה החלקה של פני השטח, הובילה ליישום הפסקות גידול לשיפור ממשקים בגידול. סקאקי, מסאקי ויושידה מאוניברסיטת טוקיו ביפן יישמו הפסקות גידול של 10 עד 100 שניות כדי להחליק את הממשקים GaAs-AlAs לרמה אטומית, לקבלת מבני בורות קוונטיים כמעט אידיאליים עם קווי פוטולומינסנציה (אנ') צרים מאוד.[16]
על סמך ההבנה שבאמצעות MBE אפשר לגדל מבנים מרובי שכבות דקות מאוד,[13] פנה אל צ'ו להתמודד עם הגידול של על-סריגים עם שכבות מתחלפות לסירוגין של GaAs ו-AlxGa1-xAs בעובי של חד-שכבות אטומיות בודדות. מבני על-סריג אלו הוצעו תאורטית ב-1970 על ידי אֶסָקִי וטְסוּ,[17] ממרכז המחקר של IBM ע"ש תומאס ווטסון ביורקטאון הייטס (אנ'), ניו יורק, שצפו כי יציגו התנגדות חשמלית שלילית. ב-1971 הדגים צ'ו גידול של על-סריגים כאלו, אך ללא האפיון החשמלי שלהם.[18] בסופו של דבר הייתה זו הקבוצה ב-IBM שהדגימה, מספר שנים מאוחר יותר, הן את יכולת הגידול של מבנה העל-סריג, והן את ההתנגדות השלילית שלו.[19][20] הם השיגו זאת במערכת MBE שבנו בעצמם עם שליטה ממוחשבת בעובי התת-שכבות המרכיבות את העל-סריג.
כבר מתחילת העבודה בשיטת ה-MBE היה ברור שעל מנת שתהיה לה תרומה למימוש התקנים, לא מספיק לגדל שכבות עם איכות גבישית גבוהה, אלא שהיא צריכה לאפשר גידול שכבות מסוממות. לשם כך צריך היה להוסיף לריאקטור תאים שיכילו את היסודות המשמשים לסימום השכבות המגודלות. אלא שהיסודות שבהם השתמשו לסימום בשיטות האפיטקסיה הקודמות לא התאימו ל-MBE. למשל, בגידול GaAs ב-LPE השתמשו לסימום סוג n בטלוריום, אבל נמצא שהוא מגיב עם שטף הארסן בריאקטור ה-MBE. כבר ב-1971 מצאו צ'ו והאיאשי שסיליקון מתאים לסימום סוג n של GaAs,[21] בעוד שגרמניום הוא מסמם אמפוטרי המניב n-GaAs כשהוא מגודל בתנאי עודף ארסן, ו-p-GaAs בעודף גליום.[22] קבלת p-GaAs בתנאי הגידול המועדפים (עודף ארסן) התבררה כקשה יותר. אבץ ומגנזיום, בהם השתמשו קודם, התגלו כבעייתיים ב-MBE בגלל לחץ אדים גבוה מאוד או מקדם הדבקות נמוך לפני השטח. הפתרון נמצא שוב במעבדות בל על ידי שימוש בבריליום כמסמם סוג p.[23] ואכן, אל צ'ו הדגים בשנות ה-70 המוקדמות של המאה ה-20 מימוש של התקנים אלקטרוניים שונים בגידול MBE של GaAs. לדוגמה: דיודת וורקטור (אנ'), דיודת IMPATT (אנ') (impact ionization avalanche transit time) וטרנזיסטור תוצא שדה (FET) מבוסס מחסום שוטקי (אנ').[24]
בשלב זה היה ברור לחוקרים במעבדות בל שהודות לשליטה הטובה בעובי השכבות המגודלות יש ל-MBE יתרון בגידול שכבות למימוש דיודות לייזר מבוססות מבנה מעורב כפול (אנ') (double heterostructure - DH) על פני שיטת ה-LPE המסורתית. לשיפור זרם הסף של הלייזר נדרשה הקטנה של עובי השכבה הפעילה בו, ואכן ב-1974 צ'ו הצליח לגדל מבנה לייזר DH עם שכבה פעילה דקה עד כדי 0.2 מיקרון, דקה פי 2–3 מאשר השיגו באמצעות LPE.[25] אבל, כדי לקבל זרם סף נמוך, היה עליו להרפות את השכבות לאחר גידולן בטמפרטורה גבוהה של 750–850 מעלות צלזיוס למשך מספר שעות. לאחר שיפורים שונים ברכיבים של מערכת הגידול הצליחו במעבדות בל להציג פעילות רציפה (cw) של הלייזר בטמפרטורת החדר.[26] הסתבר, עם זאת, שהבעיה היא הרגישות של השכבות הכוללות אלומיניום במבנה הלייזר GaAs-AlGaAs לזיהום בחמצן שיורי שהיה קיים במערכות ה-UHV של אז. מערכות אלו נפתחו לפני כל הטענת מצע לגידול, ולכן ספחו כמויות גדולות של חמצן ואדי מים שהיה קשה לסלקן מתא הגידול. הוספת תא מיוחד להטענה, עם אפשרות לחימום המצע לסילוק אדי המים הספוחים, בטרם הכנסתו לתא הגידול, כך שהראקטור עצמו נפתח ונחשף לאוויר רק לעיתים רחוקות, היו נקודת המפתח בהשגת זרמי סף נמוכים מאוד ללייזרים.[27] השיפור הבא בזרם הסף של הלייזרים ניצל היטב את יכולות ה-MBE במבנה שכלל בור קוונטי המוקף בשכבות AlGaAs עם הרכב מדורג - graded-index separate-confinement heterostructure (GRIN-SCH) lasers.[28] כך הפכה שיטת ה-MBE לכלי חשוב בייצור של דיודות לייזר במקביל לשיטת ה-MOVPE לגידול התקנים אלו.[29] היישום המסחרי-תעשייתי הראשון של שיטת ה-MBE היה בחברת רוהם (Rohm Semiconductor) היפנית, עבור ייצור של דיודות לייזר DH מ-GaAs-AlGaAs עבור נגני דיסקים.[30]
עד תחילת שנות ה-80 של המאה ה-20 הוכח, אם כן, ששיטת ה-MBE היא שיטת אפיטקסיה אמינה ומעשית, עם פוטנציאל ליישום עתידי בפיתוח וייצור התקנים חשמליים ואלקטרו-אופטיים, והובנו רבים מצדדיה התאורטיים והמעשיים. כל זאת בעיקר על ידי העבודה במעבדות בל ב-GaAs-AlGaAs, ובעיקר בזכות פעילותו של אל צ'ו. אבל גם בזכות המחקרים והפיתוחים במקומות אחרים בארצות הברית (IBM, MIT) ובארצות אחרות: אנגליה, גרמניה ויפן; ובמערכות חומרים אחרות (סיליקון וגרמניום, חומרים ממשפחות החומרים IV-VI ו-II-VI, ותרכובות III-V המכילות פוספידים (אנ') ואנטימונידים (אנ')), ובכלל זה חומרים עם אי-תאום סריגי. כל העבודה הרבה והמוצלחת הזו נעשתה במערכות UHV שנועדו לחקר פני השטח של המוצקים והוסבו על ידי החוקרים לגידולי MBE על ידי הוספת רכיבים נדרשים כגון תאי אפוזיה ומערכת RHEED. משלב זה החל תיעוש השיטה עם הכניסה של חברות מסחריות לבניה של מערכות MBE ייעודיות. בתחילה מערכות מחקריות עם תאים קטנים לגידול על מצעים בודדים בגודל קטן, ומאוחר יותר עם תאים גדולים לגידולי רב-מצעים גדולים עם אוטומציה מלאה. החברות הראשונות לרכוב על גל זה היו Varian (אנ') בארצות הברית, Vacuum Generators (VG) באנגליה, Riber בצרפת, ו-Anvela ו-Eiko ביפן.
MBE בישראל[עריכת קוד מקור | עריכה]
- המכון התת-מיקרוני מיסודו של פרופ' מוטי הייבלום, מכון ויצמן למדע, רחובות - מערכות MBE מחקריות מתוצרת Riber (צרפת) עבור משפחת החומרים III-V.[31][32]
- המעבדה למדע פני שטח וננו-מבנים (פרופ' אילן גולדפרב), המחלקה למדע והנדסה של חומרים, הפקולטה להנדסה, אוניברסיטת תל אביב - מערכת MBE בבניה עצמית.[33]
- הפקולטה להנדסת חשמל ומחשבים (פרופ' ליאור קורנבלום), הטכניון, חיפה - מערכת MBE מחקרית GENxplor מתוצרת Veeco (ארצות הברית) לגידול פרובסקיטים (perovskites).[34]
- המרכז הישראלי לפוטוניקה מתקדמת, יבנה - מערכת MBE דו-ריאקטורית GEN20 מתוצרת Veeco (ארצות הברית) עבור משפחת החומרים III-V.[35]
- SCD - SemiConductor Devices, מכון לשם - שתי מערכות MBE ייצוריות GEN200 מתוצרת Veeco (אנ') (ארצות הברית) עבור משפחת החומרים III-V.[36][37][38]
ראו גם[עריכת קוד מקור | עריכה]
- אפיטקסיה
- גידול גבישים
- מבנה גבישי
- קריסטלוגרפיה
- אפיטקסיה מפאזת אדים אורגנומתכתיים (MOVPE)
- אפטיקסיה מהפאזה הנוזלית (LPE)
לקריאה נוספת[עריכת קוד מקור | עריכה]
- A. Cho Ed. Molecular Beam Epitaxy (Key Papers in Applied Physics), AIP, New York, NY, 1994, ISBN 1563961326
- Robin F.C. Farrow Ed., Molecular Beam Epitaxy: Applications to Key Materials, Noyes, Park Ridge, NJ, 1995, ISBN 0815513712
- Marian A. Herman and Helmut Sitter, Molecular Beam Epitaxy: Fundamentals and Current Status, Springer, Berlin, 1996, ISBN 9783642800627
- John Orton and Tom Foxon, Molecular Beam Epitaxy: A Short History, Oxford University, Oxford, 2015, ISBN 9780199695829
- Mohamed Henini Ed., Molecular Beam Epitaxy: From Research to Mass Production, Elsevier, Amsterdam, 2018, ISBN 9780128121368
- Hajime Asahi and Yoshiji Horikoshi Eds, Molecular Beam Epitaxy: Materials and Applications for Electronics and Optoelectronics, Wiley & Sons, Hoboken, NJ, 2019, ISBN 9781119355014
קישורים חיצוניים[עריכת קוד מקור | עריכה]
- Molecular Beam Epitaxy Suite, Lancaster University Physics Department, YouTube, 5 באוג׳ 2015
- Aditya Pradipta, Material Science : Molecular Beam Epitaxy (MBE), YouTube, 2 באפר׳ 2019
- אנימציה: CEMS-UMN, The Hybrid Molecular Beam Epitaxy Technique for Complex Oxides, YouTube, 20 במרץ 2014
הערות שוליים[עריכת קוד מקור | עריכה]
- ^ 1 2 J. H. Neave, B. A. Joyce, P. J. Dobson and N. Norton, Dynamics of film growth of GaAs by MBE from Rheed observations, Applied Physics A 31, 1983, עמ' 1-8
- ^ J. H. Neave, P. J. Dobson, B. A. Joyce and J. Zhang, Reflection high‐energy electron diffraction oscillations from vicinal surfaces – a new approach to surface diffusion measurements, Appl. Phys. Lett. 47/2, 1985, עמ' 100-102
- ^ A. Cho, M.B. Panish, and I. Hayashi, Molecular beam epitaxy of GaAs, AlxGa1-xAs and GaP, Proceedings of the Third International Symposium on GaAs and Related Compounds, 1970, עמ' 18-29
- ^ J. E. Davey and T. Pankey, Structural and Optical Characteristics of Thin GaAs Films, Journal of Applied Physics 35/4, 1964, עמ' 2203–2209
- ^ J. E. Davey and T. Pankey, Epitaxial GaAs Films Deposited by Vacuum Evaporation, Journal of Applied Physics 39/4, 1968, עמ' 1941-1948
- ^ K. G. Günther, Aufdampfschichten aus halbleitenden Ill-V-Verbindungen, Zeitschrift für Naturforschung A 13/12, 1958, עמ' 1081-1089 (בגרמנית)
- ^ B. A. Joyce, Growth and perfection of chemically-deposited epitaxial layers of Si and GaAs, Journal of crystal growth 3-4, 1968, עמ' 43-59
- ^ J. R. Arthur and J. J. LePore, GaAs, GaP, and GaAsxP1-x Epitaxial Films Grown by Molecular Beam Deposition, Journal of Applied Physics 6/4, 1969, עמ' 545-548
- ^ J. R. Arthur, Interaction of Ga and As2 Molecular Beams with GaAs Surfaces, Journal of Applied Physics 39/8, 1968, עמ' 4032-4034
- ^ 1 2 A. Y. Cho, Morphology of Epitaxial Growth of GaAs by a Molecular Beam Method: The Observation of Surface Structures, Journal of Applied Physics 41/7, 1970, עמ' 2780-2786
- ^ A. Y. Cho, GaAs Epitaxy by a Molecular Beam Method: Observations of Surface Structure on the (001) Face, journal of Applied Physics 42/5, 1971, עמ' 2074–2081
- ^ J. H. Neave and B. A. Joyce, Structure and stoichiometry of {100} GaAs surfaces during molecular beam epitaxy, Journal of Crystal Growth 44/4, 1978, עמ' 387—397
- ^ 1 2 A. Y. Cho, Film Deposition by Molecular-Beam Techniques, Journal of Vacuum Science & Technology 8/5, 1971, עמ' S31–S38
- ^ J.J. Harris, B A. Joyce, and P.J. Dobson, Oscillations in the surface structure of Sn-doped GaAs during growth by MBE, Surface Science 103/1, 1981, עמ' L90-L96
- ^ C. E.C. Wood, RED intensity oscillations during MBE of GaAs, Surface Science 108/2, 1981, עמ' L441-L443
- ^ H. Sakaki, M. Tanaka, and J. Yoshino, One Atomic Layer Heterointerface Fluctuations in GaAs-AlAs Quantum Well Structures and Their Suppression by Insertion of Smoothing Period in Molecular Beam Epitaxy, Japanese Journal of Applied Physics 24/6, 1985, עמ' L417-L420
- ^ L. Esaki and R. Tsu, Superlattice and Negative Differential Conductivity in Semiconductors, IBM Journal of Research and Development 14/1, 1970, עמ' 61-65
- ^ A. Y. Cho, Growth of Periodic Structures by the Molecular‐Beam Method, Applied Physics Letters 19/11, 1971, עמ' 467–468
- ^ L. L. Chang, L. Esaki, W. E. Howard, and R. Ludeke, The Growth of a GaAs–GaAlAs Superlattice, Journal of Vacuum Science & Technology 10/1, 1973, עמ' 11-16
- ^ L. L. Chang, L. Esaki, W. E. Howard, R. Ludeke, and G. Schul, Structures Grown by Molecular Beam Epitaxy, Journal of Vacuum Science & Technology 10/5, 1973, עמ' 655–662
- ^ A. Y. Cho and I. Hayashi, Epitaxy of silicon doped gallium arsenide by molecular beam method, Metallurgical Transactions 2/3, 1971, עמ' 777–780
- ^ A. Y. Cho and I. Hayashi, P‐N Junction Formation during Molecular‐Beam Epitaxy of Ge‐Doped GaAs, Journal of Applied Physics 42/11, 1971, עמ' 4422–4425
- ^ M. Ilegems, Beryllium doping and diffusion in molecular‐beam epitaxy of GaAs and AlxGa1−xAs, Journal of Applied Physics 48/3, 1977, עמ' 1278–1287
- ^ A. Y. Cho and J. R. Arthur, Molecular beam epitaxy, Progress in Solid State Chemistry 10/3, 1975, עמ' 157-191
- ^ A. Y. Cho and H.C. Casey, Jr., GaAs–AlxGa1−xAs double‐heterostructure lasers prepared by molecular‐beam epitaxy, Applied Physics Letters 25/5, 1974, עמ' 288–290
- ^ A. Y. Cho, R. W. Dixon, and H. C. Casey, Jr., Continuous room‐temperature operation of GaAs‐AlxGa1−xAs double‐heterostructure lasers prepared by molecular‐beam epitaxy, Applied Physics Letters 28/9, 1976, עמ' 501–503
- ^ W. T. Tsang, F. K. Reinhart, and J. A. Ditzenberger, Very low current threshold GaAs‐AlxGa1−xAs double‐heterostructure lasers grown by molecular beam epitaxy, Applied Physics Letters 36/1, 1980, עמ' 11-14
- ^ W. T. Tsang, A graded‐index waveguide separate‐confinement laser with very low threshold and a narrow Gaussian beam, Applied Physics Letters 39/2, 1981, עמ' 134-137
- ^ J. J. Coleman, The development of the semiconductor laser diode after the first demonstration in 1962, Semiconductor Science and Technology 27/9, 2012, עמ' 090207
- ^ Haruo Tanaka and Masato Mushiage, MBE as a production technology for A1GaAs lasers, Journal of Crystal Growth 111, 1991, עמ' 1043-1046
- ^ V.Y. Umansky, Weizmann Institute of Science, Department of Condensed Matter Physics - Molecular Beam Epitaxy for high mobility semiconductor, March 9, 2024
- ^ V. Umansky, M. Heiblum, Y. Levinson, J. Smet, J. Nuebler, and M. Dolev, MBE growth of ultra-low disorder 2DEG with mobility exceeding 35 x 106 cm2/V s, Journal of Crystal Growth 311, 2009, עמ' 1658–1661
- ^ Surface Science and Nanostructures Laboratory, Last retrieved on March 9, 2024
- ^ L. Kornblum, Oxide Electronics Lab, Last retrieved on March10, 2024
- ^ [Israel Center for Advanced Photonics (ICAP) https://isorad.co.il/photonic/], Last retrieved on March 9, 2024
- ^ SCD Core Technologies, Last retrieved on March 9, 2024
- ^ SCD expands capacity with Veeco MBE system, Compound Semiconductor, May 12, 2016
- ^ Olga Klin et al., A study of MBE growth-related defects in InAs/GaSb type-II supperlattices for long wavelength infrared detectors, Journal of Crystal Growth 425, 2015, עמ' 54–59
